0 引言
集成电路产业是维持我国经济发展的支柱性产业之一,其中半导体晶圆的制程工艺与质量控制是晶圆生产过程中尤为重要的环节[1]。晶圆生产企业在晶圆制造完成之后、封装之前,需要对晶圆的电学性能进行晶圆允收测试(wafer acceptance test, WAT),用以反映晶圆制造的质量情况[2]。而晶圆良率是指通过晶圆针测(circuit probing, CP)过程后,依据各项测试功能的通过情况所得到的合格晶粒数与整片晶圆上进行测试的晶粒数的比值。利用WAT参数构建晶圆良率预测模型[3],有助于缩短生产时间、减少检测设备投入、提高晶圆生产质量[4]。
针对WAT参数之间数据体量大、数据间冗余性突出、关系复杂、关键参数不显著的问题,传统基于统计过程控制(statistical process control, SPC)的异常参数识别方法在大规模参数识别、参数识别效率、自动识别等方面受到一定的限制[5]。
目前文献中通常采用专家经验法、关联关系分析法、主成分分析法、聚类分析法、基于信息熵分析法、基于启发式规则分析法对晶圆的关键质量参数进行识别。CHIEN等[6]通过专家经验筛选出12个高相关WAT因子,并以该高相关因子作为模型输入,设计了基于改进的偏最小二乘(modified partial least square, mPLS)分析方法,该方法需要借助专家经验进行关键参数筛选,对于经验尚浅的质量分析人员来说难以快速掌握该项技能;CHANG等[7]利用WAT参数与CP良率之间的相关性,筛选出关键WAT参数,并通过反向传播神经网络(back propagation neural network, BPNN)和广义回归类神经网络(general regression neural network, GRNN)分析方法,实现了良率预测模型的建立,而该方法主要考虑WAT参数中单一变量与CP良率的相关性,对组合变量与良率之间的相关性缺乏考虑;RAVI等[8]通过主成分分析法(principal component analysis, PCA)对高维数据进行特征和维度缩减,进而利用Logistic回归分析方法进行数据挖掘,而该方法通过PCA将高维参数转化为低维不相关的线性综合指标,丢失了原有数据的物理信息,难以从源头对问题原因进行分析调控;HSU[9]通过聚类方法将高复杂度的参数进行相似特征聚类,再通过决策树推论法则(decision tree induction)将参数聚类结果进行群聚规则推断,从而构建完整的数据挖掘架构,该方法在利用决策树进行决策分析时还需要借鉴专家经验进行决策节点的设定,一定程度上制约了对关键参数的自动挖掘能力;汪俊亮等[10]设计了基于信息熵方法的关键参数选择方法,综合度量参数间的相关性、冗余性与互补性,提出过滤式关键参数识别算法,滤取影响工期波动的关键参数子集,该方法通常单独地对每个特征的预测能力进行衡量,特征选择效率较高,但对噪声敏感度、组合变量的预测能力无法有效衡量;NI等[11]设计了基于改进粒子群算法与邻近算法(KNN)相结合的晶圆生产周期时间预测方法,通过改进粒子群算法对输入参数进行分析,找出影响晶圆生产时间的最佳输入参数组合,该方法的关键变量选择过程可以胜过大多数中小型数据集的其他启发式方法,但对于高维特性的WAT参数而言,该方法在计算过程中需要耗费大量的时间成本。通过上述分析可知,各方法由于自身的局限性,难以在晶圆参数规模不断扩大、约束因素逐渐增多的情况下,对晶圆的关键WAT参数进行自动、高效识别。
针对现有关键参数识别方法中,考虑单一参数与目标之间的关联关系而牺牲模型稳定性[12],考虑组合参数对目标的关联影响而牺牲时间效率,以及WAT参数中存在的高维特性、冗余特性和关键参数不显著的特点,本文提出基于混合式特征选择模型的晶圆允收测试关键参数识别方法。首先设计基于互信息的过滤式参数预筛选方法,依据最大相关与最小冗余特性对WAT参数进行过滤式筛选,剔除部分不相关特征,降低数据集维度与运算时间;然后设计遗传算法与BPNN相结合的封装式关键参数识别模型,通过遗传算法实现候选参数组合的编码、寻优,再利用BPNN模型对晶圆良率进行预测,以闭环形式实现关键WAT参数的封装式特征精选。
1 基于混合式特征选择的WAT关键参数识别框架
面向WAT参数的混合式特征选择方法如图1所示。首先针对原始晶圆WAT参数中存在的缺失值、异常值、量纲差异等问题进行数据预处理,在此基础上设计基于互信息的过滤式参数预筛选方法,用以获得与良率值有较高关联性的参数,与此同时计算各参数之间的关联性,以反映WAT参数间的冗余特性,并结合最大相关最小冗余特性对WAT参数逐个进行过滤式预筛选;然后设计基于遗传算法(GA)与BPNN(GA-BPNN)的封装式特征精选模型,以反向传播神经网络的预测准确率和最小特征子集个数作为适应度函数,进行多目标优化,实现WAT参数组合与良率之间的复杂关系建模,输出影响晶圆良率的WAT关键参数。
2 基于互信息的WAT参数过滤式预筛选方法
2.1 数据预处理
WAT是指在被测芯片切割道器件上施加一定大小和方向的电流或电压,并监控被测器件的电压或电流情况,以反映被测器件的电学特性,从而达到监控工艺和产品质量目的的一种测试方法。由于设备异常、电流冲击等原因,使得所记录

图1 基于混合式特征选择的关键晶圆允收测试参数识别框架图
Fig.1 Framework of key WAT parameters based on hybrid feature selection
的WAT参数中存在缺失值、异常值等情况,对于此类问题考虑到数据集本身体量大的特点,对WAT参数中存在的缺失值、异常值进统计、筛选与剔除[13-14]。对于各WAT参数在量纲上的差异,采用最大最小归一化的数据处理方法将数据映射到0~1之间,实现数据的标准化,从而获得便于后期数据分析、预测建模所需要的输入参数。
2.2 相关性度量方法
在半导体复杂的制造过程中,晶圆上的晶粒由于某些工艺制程问题导致功能异常,会直接影响最终的晶圆良率,因此晶圆良率与特定的WAT参数间有着密不可分的关系与影响;而且由于半导体制程步骤的繁复以及参数间存在复杂的交互效应,使得WAT参数与良率之间表现出复杂的关联特性,工程师难以在短时间内有效找出异常原因,从而造成良率损失。因此设计基于互信息的相关性分析方法,将所有WAT参数逐个与晶圆良率进行相关性分析[15],并从中预筛选出与良率具有较强相关性的WAT参数很有必要。
互信息是描述两个随机变量之间相互依存关系强弱的信息度量方法,对于WAT参数与良率值之类的连续随机变量,采用下式所示的连续随机变量互信息求取方法[2],分别对各WAT参数与晶圆良率值逐个进行单变量关联分析:
(1)
式中,xi、y分别为WAT参数Xi与良率值Y的子集;p(xi, y)为当前WAT参数Xi与良率值Y的联合概率密度函数;p(xi)和p(y)分别为当前WAT参数Xi和良率值Y的边缘概率密度函数。
通过互信息得到每个WAT参数与晶圆良率的互信息值,之后再对WAT参数与良率情况的互信息值进行倒序排列,得到与晶圆良率相关联的WAT参数。
2.3 冗余性度量方法
在实际晶圆生产过程中,所集成的WAT参数值是以该晶圆片上某个参数的均值、最大值、最小值以及标准差的形式进行存储的,例如:对某一晶圆片上的漏电流进行测试,最终会将该晶圆片上所有晶粒漏电流的均值、最大值、最小值以及标准差值同时集成于晶圆数据管理系统中,因而WAT参数间存在着属性重复、关联性强的特性,表现出较强的冗余特性。而数据冗余不仅会占用信息存储量,还会影响后期模型建立的稳定性,因此采用互信息对WAT参数进行冗余性度量[16],从众多冗余数据中筛选出具有代表性的关键数据,实现数据的维度缩减、数据冗余减少。
利用下式的连续随机变量互信息值计算公式计算各WAT参数之间的相关性[17]:
(2)
式中,xi、xj分别为WAT参数Xi与Xj的子集;p(xi,xj)为当前WAT参数Xi与Xj的联合概率密度函数,p(xi)和p(xj)分别为当前WAT参数Xi和Xj的边缘概率密度函数。
互信息值越高表明变量间相关性越高、冗余性越突出。
2.4 最大相关最小冗余度量方法
在WAT测试过程中,由于所需要测试的参数众多,使得最终集成的WAT参数集合的数据维度高,难以对高维概率密度进行有效估计,且高维特征选择耗时长、效率低,为了有效进行特征预筛选,从最小冗余最大相关角度出发[18],进一步设计如下基于互信息的最大相关最小冗余特征预筛选评价指标[19]:
(3)
式中,J(f)为基于互信息的特征预筛选评价函数;f为所选择的WAT特征参数集合,且f∈X;Ic(X;Y)为各WAT参数与晶圆良率值的互信息值;S为已选择的特征参数子集;|S|为当前已选择特征参数的个数;Ir(Xi;Xj)为各WAT参数之间的互信息值。
所设计的最大相关最小冗余算法评价函数的终止条件是在一定迭代次数基础上,评价函数J(f)达到最大值,此时得到相应的特征子集为fi。通过最大相关最小冗余算法,将WAT特征参数与良率值间最大相关性的选择标准和特征之间最小冗余性的选择标准结合起来,可实现WAT参数的预筛选过程。
此时所筛选出来的WAT参数由于仅考虑了单一WAT参数变量与晶圆良率的相关性,还不能有效反映WAT参数组合对晶圆良率的关联影响,因而还需要对WAT参数变量组合对晶圆良率的影响情况进一步分析,得到影响晶圆良率的WAT关键参数。
3 基于GA-BPNN的WAT参数封装式精选方法
基于GA-BPNN的WAT参数选择方法以封装式特征选择模型为基础,将后续的学习算法嵌入到特征选择过程中,通过测试特征子集在学习算法上的预测性能,对不同特征子集进行优劣评定,实现WAT参数的特征精选[20-21]。如图2所示,利用遗传算法(GA)实现预筛选WAT参数的编码、更新,采用BPNN深度学习模型建立WAT参数与晶圆良率之间的复杂非线性映射关系,对遗传算法中的个体进行适应度评价[22]。

图2 基于GA-BPNN的组合WAT参数选择流程图
Fig.2 Flow chart of GA-BPNN-based combined
WAT parameter selection
3.1 子集产生
通过随机选取方式进行候选WAT参数特征子集的初始选择[23],并采用二进制编码方式对候选WAT参数进行编码,将特征变量转换为染色体。
3.2 子集评价
WAT关键参数选择方法以提升晶圆良率预测准确率以及减少所选择的特征数量为优化目标[24],因此设计如下适应度函数[25]:
(4)
(5)
式中,aBPNN为BPNN模型的预测准确度值。
该函数具有两个预定权重:WA表示BPNN模型预测准确度的权重值;WF表示所选特征个数的权重值。在模型优化过程中,若认为BPNN模型预测准确性最重要,则WA精度值可调整至100%,且通常WA精度值可根据需求设置在75%~100%之间,而WF精度值通常设置在0~25%之间。Fi的取值分别为0或1,Fi=0表示当前特征i是在互信息预筛选中舍弃的特征;Fi=1表示当前特征i是在互信息预筛选中保留的特征。Ic(Xi;Y)表示WAT特征参数Xi与晶圆良率值Y的互信息值,用以衡量当前特征的重要性程度。通过该适应度函数的设计,可以将具有高适应值的染色体尽可能地保存到下一代,因此也可根据需求对其中参数进行设定。
3.3 子集寻优
GA-BPNN算法将WAT参数以组合特征形式建立与晶圆良率的关联关系,通过交叉、变异操作[26],在一定迭代次数的基础上,以适应度函数f0达到最大值时所挑选出的特征子集作为最优特征子集,实现WAT参数精选过程。
4 试验分析
首先采用UCI标准数据集,对混合式特征选择方法的有效性及可靠性进行验证,然后利用WAT实例数据,验证所提方法的有效性。
4.1 标准数据集试验
所选择的UCI标准数据集[27]包括低维度的鲍鱼数据集(abalone dataset)、葡萄酒质量数据集(wine quality dataset),以及高维度的德黑兰住宅楼数据集(residential building dataset)和多层建筑多层室内定位数据集(UJI indoor loc dataset),分别进行鲍鱼年龄、葡萄酒质量等级、房价、住宅楼层位置预测中的参数选择试验。采用最小冗余-最大相关(minimal-redundancy and maximal-relevance, mRMR)过滤式方法和GA-BPNN封装式方法,与所提出的混合式特征选择方法进行对比试验,并将mRMR方法所筛选的特征值作为BPNN模型的输入参数进行预测试验,形成基于mRMR-BPNN的过滤预测模型。为了增加标准数据集样本中的冗余特性和关联特性,对以上4个标准数据集进行数据扩充与增强,并通过线性叠加的方式添加冗余特征[28],用以检验不同数据情况下模型的稳定性,数据集原始特征个数以及所添加的随机噪声特征个数如表1所示。在试验过程中,以最小平均相对误差情况下所选择出的特征个数作为模型评价的指标,并对所选择的特征进行分析,检验是否能够有效剔除噪声特征,试验结果如表1所示。
表1 标准数据集特征选择试验
Tab.1 Standard dataset feature selection test

维度信息数据集原始特征个数增加特征个数最小平均相对误差最小平均相对误差下所选特征个数mRMR-BPNNGA-BPNN本文方法mRMR-BPNNGA-BPNN本文方法低维度数据abalone840.5890.3420.285966wine quality1150.5520.4130.416131011高维度数据residential building104200.6260.3090.15711010195UJI indoor loc528200.5150.3140.141534520486
由表1可知,3种特征选择方法均能过滤大多数噪声参数,并且能够减小预测模型的输入维度,以缩短预测模型的训练与运算时间。对于低维度数据而言,mRMR-BPNN方法相对GA-BPNN方法以及本文方法的最小平均相对误差更大,且所筛选参数数量多于另外两种方法筛选的参数数量,而本文方法筛选出的参数数量与GA-BPNN方法筛选出的参数数量持平,甚至略多于GA-BPNN方法筛选出的参数数量;对于高维度数据而言,本文提出的混合式特征选择方法能够保证在高准确率基础上选择出更少的特征参数,在应对高维数据的关键参数提取过程中体现了一定的优越性。
4.2 工程实例
4.2.1 WAT参数集
WAT数据是检测晶圆电路设备的电气测试参数,主要包括与MOS管性能相关的开启电压漏电流、饱和电流、击穿电压等,与电阻电容类相关的有片电阻、接触电阻等,与栅氧层特性相关的栅氧击穿电压、栅氧层厚度等,主要WAT测试对象以及测试项的相关参数数量如表2所示。
4.2.2 实验结果与讨论
本文选用上海市某300 mm晶圆生产线上的实际数据进行模型分析与验证。通常在晶圆生产过程中以Lot为单位,而每个Lot中包含25片晶圆。在该晶圆产品进行电性测试过程中,需要分别对每一片晶圆上的432个参数进行测试,同批生产的晶圆片分为8组,编号分别从Lot_ID_A至Lot_ID_H,共计8 000多片,选取晶圆实际生产线上8 000多组数据集中80%的晶圆WAT测试数据与其对应的良率值作为训练集进行有监督的回归训练,利用剩余20%的数据作为测试集进行测试验证。
表2 WAT参数信息
Tab.2 Information about WAT parameters

序号参数名称相关参数数量(个)1漏源击穿电压(BVDS)242器件关闭状况下的漏电流(IOFF)243连接电阻(RCFV)724电流模式下的绝缘性(SPAFI)405工作状态下的饱和电流(IDSAT)406MOSFET电容器(VBG)327场效应管的开启电压(VTFM1)88常数电流模式下的开启电压(VTI)169表面电阻(RSFV)3610结型二极管连接处漏电流(JLEA)811累积模式下电容器容量(TXA)1612线性区域的阈值电压(VTI)4813结型二极管连接电容(CJ)814聚金属连续性电阻值(CONTI)4015电容器漏电流(GLK)416由热电子引起的基底电流(ISUB)817场效应管的开启电压(VTFPO)8共计432
(1)模型参数设置。本文所提出的混合式特征选择方法主要涉及的超参数包括:过滤式预筛选过程中的迭代次数k1,封装式精选过程中遗传算法的初始化种群数p、交叉操作概率值r、变异操作概率值m,BPNN模型结构的层数l、各层节点数n、迭代次数k2。其中迭代次数k1值通过最大相关最小冗余适应度函数计算后,算法收敛趋于稳定时的迭代次数为500,因而在每次试验过程中设置k1=500;遗传算法的初始化种群数p值是依据特征预筛选结果自适应设置的,通常预筛选特征数量在130~150之间,交叉操作概率值r、变异操作概率值m借鉴现有文献中的设置方法分别设为0.8、0.01[29];对于BPNN模型,通过正交试验可知,当模型层数l设置为3,输入层节点数依据预筛选特征个数自适应设置,而中间隐含层则以等差数列格式递减设置,输出层节点设置为1时预测准确度最佳,并且当迭代次数k2值达到3 000次时模型收敛趋于稳定,故预测过程每次所设置的迭代次数k2设置为3 000。
(2)预测结果对比试验。分别将WAT训练数据与测试数据代入mRMR-BPNN模型、GA-BPNN模型以及本文所提出的混合式特征选择模型中进行验证,8组预测输出良率值与真实良率值绝对误差对比情况如图5所示。对比不同Lot晶圆的良率预测情况可知,三种预测模型在Lot_ID_A数据集中的预测误差值显著高于其他几组Lot中的预测误差值,究其原因主要是Lot_ID_A批次的晶圆片属于晶圆批量生产的试制阶段,晶圆生产的工艺参数及制程还未稳定,等到工艺参数及制程工艺稳定之后,晶圆良率误差值普遍减小,因而中后期所生产的晶圆良率预测误差值逐渐减少,并趋于稳定;对每组Lot晶圆而言,3种良率预测模型的预测绝对误差值差异显著,mRMR-BPNN方法的预测误差值较大,GA-BPNN方法预测误差值相对mRMR-BPNN方法而言预测误差值要小,而本文所提混合式特征选择方法的预测误差值最小,优于另外两种对比方法。
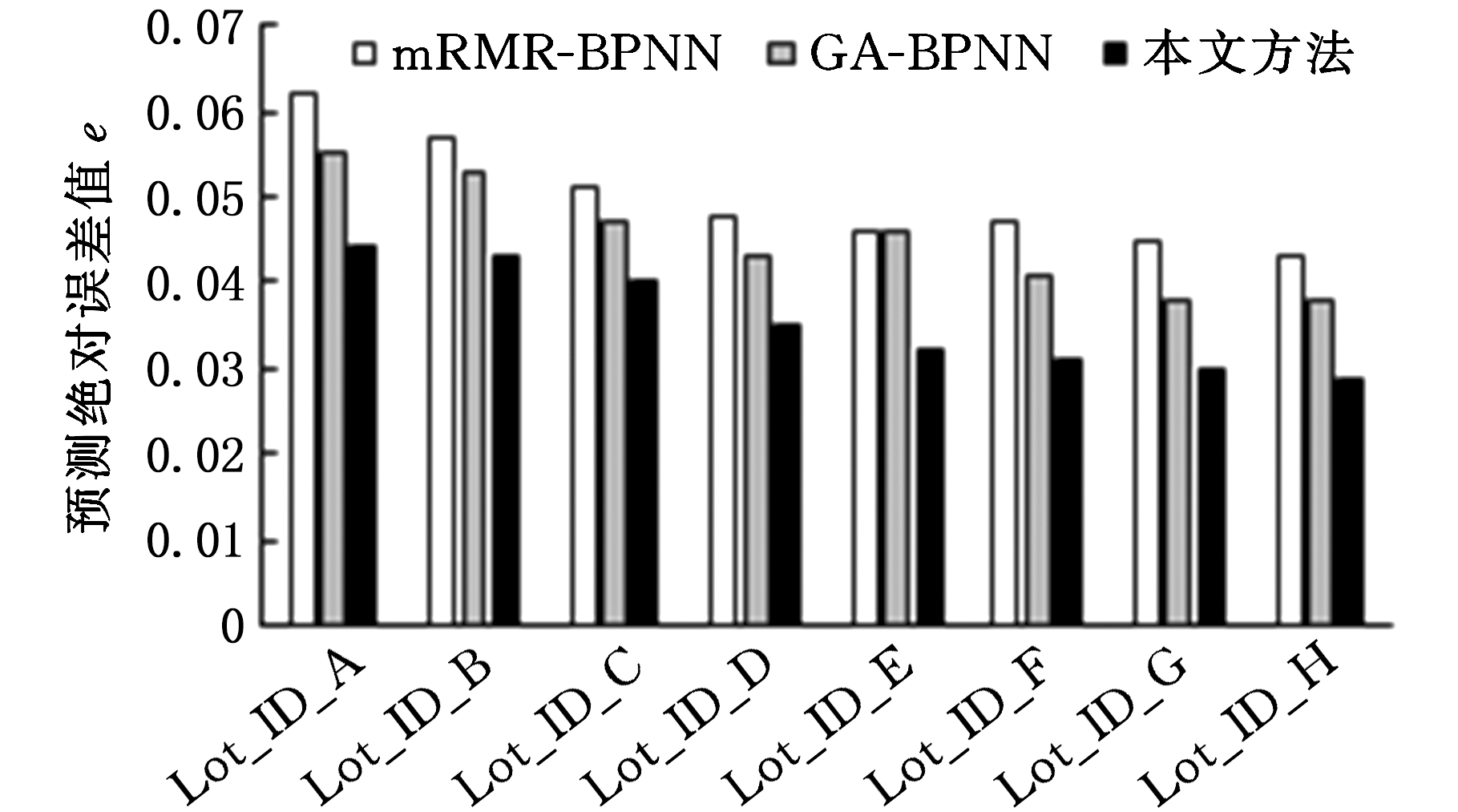
图3 8组晶圆片在3种模型下的预测绝对
误差对比图
Fig.3 Comparison chart of prediction absolute error of
8 groups of wafers under 3 models
(3)筛选结果对比试验。对8组晶圆片进行混合特征选择试验,由于混合特征选择方法是通过过滤式预筛选和封装式精选过程组合而成的,因而在实现混合特征选择时,可以得到中间过滤式预筛选过程所筛选出来的特征个数,即混合特征选择方法中预筛选的中间过程量,8组晶圆片在混合特征选择模式中预筛选出来的的特征个数以及通过封装式精选过程最终剩余的特征个数如表3所示。通过过滤式预筛选后所剩余的特征个数最多有159个,最少的仅有129个,相比原始432个参数特征,WAT参数特征能够大幅度过滤无关的噪声特征;而进一步通过封装式精选过程后剩余的特征个数最多仅63个,最少仅51个,从参数筛选的最少特征个数角度而言,混合特征选择方法能够有效保证特征参数个数的最小化,实现以少量关键特征信息反映晶圆实际良率情况的效果。
表3 混合特征选择方法各阶段参数筛选特征个数
Tab.3 The number of remaining features at each stageof hybrid feature selection method

原始特征个数过滤式预筛选后所剩特征个数封装式精选后所剩特征个数Lot_ID_A43215963Lot_ID_B43215161Lot_ID_C43214356Lot_ID_D43213353Lot_ID_E43212951Lot_ID_F43213153Lot_ID_G43213051Lot_ID_H43213152
以8组晶圆片数为基础,依据正交试验得到的算法参数,分别运用3种不同的特征选择模型,计算对应的预测结果最小平均相对误差值,以及在最小平均相对误差情况下所选择出来的最少特征参数个数,对比结果如表4所示。由试验结果分析可知,通过混合特征选择方法可以得到,在432个相关的WAT参数中仅有不到1/3的WAT参数对晶圆良率产生影响,且过滤式方法与封装式方法比本文所提混合式特征选择方法预测的误差值更大、预测准确度更低。而本文所提出的混合式特征选择方法能够实现在输入特征个数最少的情况下,实现较小的预测误差和更高的预测精度,因而具有更显著的优越性。
表4 WAT参数选择结果对比
Tab.4 Comparison of WAT parameter selection results

所选模型WAT参数个数最小平均相对误差值最小平均相对误差下所选择特征参数个数mRMR-BPNN4320.047126GA-BPNN4320.04598本文方法4320.03551
5 结论
本文针对WAT参数维度高、数据间冗余性强、关键参数不显著等问题,提出了基于混合式特征选择的关键晶圆允收测试参数识别方法。在设计基于互信息的最大相关最小冗余过滤式参数预筛选基础上,设计基于GA-BPNN模型的WAT参数精选方法,通过最大相关最小冗余方法实现单一WAT参数变量与晶圆良率的关联性分析,并且通过GA-BPNN模型实现组合WAT参数对晶圆良率的关联影响。经试验对比分析可知,本文所提混合式特征选择方法能够有效过滤WAT参数中的噪声特征信息,并以较少的WAT关键参数输入实现晶圆良率的准确预测,表现出一定的优越性。
[1] HESS C, INANI A, LIN Y, et al. Scribe Characterization Vehicle Test Chip for Ultra Fast Product Wafer Yield Monitoring[C]∥IEEE International Conference on Microelectronic Test Structures. Austin, 2006:110-115.
[2] XU H, ZHANG J, LYU Y, et al. Hybrid Feature Selection for Wafer Acceptance Test Parameters in Semiconductor Manufacturing[J]. IEEE Access, 2020, 8:17320-17330.
[3] 杨振良, 汪俊亮, 张洁, 等. 数据驱动的晶圆图缺陷模式识别方法[J]. 中国机械工程, 2019, 30(2):230-236.
YANG Zhenliang, WANG Junliang, ZHANG Jie, et al. Data Driven Wafer Pattern Defect Pattern Recognition Method[J]. China Mechanical Engineering, 2019, 30(2):230-236.
[4] 黎敏, 谢玄, 陈泽, 等. 基于函数型数据分析的半导体生产过程监控[J]. 机械工程学报, 2018, 54(16):62-69.
LI Min, XIE Xuan, CHEN Ze, et al. Monitoring of Semiconductor Manufacturing Process Based on Functional Data Analysis [J]. Journal of Mechanical Engineering, 2018, 54(16):62-69.
[5] MAI K, TUCKERMANN M. SPC Based In-line Reticle Monitoring on Product Wafers[C]∥IEEE/SEMI Conference and Workshop on Advanced Semiconductor Manufacturing 2005. Munich, 2005:184-188.
[6] CHIEN C F, LEE P C, DOU R, et al. Modeling Collinear WATs for Parametric Yield Enhancement in Semiconductor Manufacturing[C]∥13th IEEE Conference on Automation Science and Engineering (CASE). Xi’an, 2017:739-743.
[7] CHANG P Y, CHEN K T, WANG C Y. Modeling of Wafer Die Yield by WAT Parameters[J]. Journal of Quality, 2011, 18(6):519-538.
[8] RAVI V, NAVEEN N, PANDEY M. Hybrid Classification and Regression Models via Particle Swarm Optimization Auto Associative Neural Network based Nonlinear PCA[J]. International Journal of Hybrid Intelligent Systems, 2013, 10(3):137-149.
[9] HSU S Y. A Hybrid Due-date Fulfilled Forecasting Based on Clustering and Decision Trees[C]∥IEEE International Conference on Industrial Engineering & Engineering Management.New York:IEEE, 2010:6-11.
[10] 汪俊亮, 张洁. 大数据驱动的晶圆工期预测关键参数识别方法[J]. 机械工程学报, 2018,54(23):185-191.
WANG Junliang, ZHANG Jie. Big Data Driven Key Factor Identification for Cycle-time Forecasting of Wafer Lots in Semiconductor Wafer Fabrication System [J]. Journal of Mechanical Engineering, 2018, 54(23):185-191.
[11] NI J C, QIAO F, LI L, et al. A Memetic PSO Based KNN Regression Method for Cycle Time Prediction in a Wafer Fab[C]∥ World Congress on Intelligent Control & Automation. New York:IEEE, 2012:474-478.
[12] LI G Z, YANG J Y.Feature Selection for Ensemble Learning and Its Application[M]∥ Machine Learning in Bioinformatics. Hoboken :John Wiley & Sons, Inc., 2008.
[13] KHAKIFIROOZ M, CHIEN C F, CHEN Y J. Bayesian Inference for Mining Semiconductor Manufacturing Big Data for Yield Enhancement and Smart Production to Empower Industry 4.0[J]. Applied Soft Computing, 2018, 68:990-999.
[14] OOI M P L, JOO E K J, KUANG Y C, et al. Getting More from the Semiconductor Test:Data Mining with Defect-cluster Extraction[J]. IEEE Transactions on Instrumentation and Measurement, 2011, 60(10):3300-3317.
[15] ZHANG W, LI X, ACAR E, et al. Multi-wafer Virtual Probe:Minimum-cost Variation Characterization by Exploring Wafer-to-Wafer Correlation[C]∥2010 IEEE/ACM International Conference on Computer-Aided Design (ICCAD). New York :IEEE, 2010:47-54.
[16] 汪俊亮, 秦威, 张洁. 基于数据挖掘的晶圆制造交货期预测方法[J]. 中国机械工程, 2016, 27(1):105-108.
WANG Junliang, QIN Wei, ZHANG Jie. Data Mining for Orders’ LT Forecasting in Wafer Fabrication[J]. China Mechanical Engineering, 2016, 27(1):105-108.
[17] ALELYANI S, TANG J, LIU H. Feature Selection for Clustering :a Review[J]. Encyclopedia of Database Systems, 2016, 21(3):110-121.
[18] LI Y, YANG Y, LI G, et al. A Fault Diagnosis Scheme for Planetary Gearboxes Using Modified Multi-scale Symbolic Dynamic Entropy and mRMR Feature Selection[J]. Mechanical Systems and Signal Processing, 2017, 91:295-312.
[19] JO I, LEE S, OH S, et al. Improved Measures of Redundancy and Relevance for mRMR Feature Selection[J]. Computers, 2019, 8(2):42.
[20] MAFARJA M, MIRJALILI S. Whale Optimization Approaches for Wrapper Feature Selection[J]. Applied Soft Computing, 2018, 62:441-453.
[21] JADHAV S, HE H, JENKINS K W, et al. Information Gain Directed Genetic Algorithm Wrapper Feature Selection for Credit Rating[J]. Applied Soft Computing, 2018, 69:541-553.
[22] VANAJA R, MUKHERJEE S. Novel Wrapper-based Feature Selection for Efficient Clinical Decision Support System[C]∥International Conference on Intelligent Information Technologies. Singapore, 2018:113-129.
[23] MISTRY K, ZHANG L, NEOH S C, et al. A Micro-GA Embedded PSO Feature Selection Approach to Intelligent Facial Emotion Recognition[J]. IEEE Transactions on Cybernetics, 2016, 47(6):1496-1509.
[24] LU H, CHEN J, YAN K, et al. A Hybrid Feature Selection Algorithm for Gene Expression Data Classification[J]. Neurocomputing, 2017, 256:56-62.
[25] HUANG C L, WANG C J. A GA-based Feature Selection and Parameters Optimization for Support Vector Machines[J]. Expert Systems with Applications, 2006, 31(2):231-240.
[26] WANG S, ZHANG N, WU L, et al. Wind Speed Forecasting Based on the Hybrid Ensemble Empirical Mode Decomposition and GA-BP Neural Network Method[J]. Renewable Energy, 2016, 94:629-636.
[27] UCI. Machine Learning Repository[EB/OL]. [2020-03-10].https:∥archive.ics.uci.edu/ml/index.php.
[28] GAO W, HU L, ZHANG P, et al. Feature Selection Considering the Composition of Feature Relevancy[J]. Pattern Recognition Letters, 2018, 112:70-74.
[29] YU C M, KUO C J, CHIU C L, et al. Product Mix Optimization under Required Cycle Time for Semiconductor Wafer Fabrication[C]∥2018 International Symposium on Semiconductor Manufacturing (ISSM). Tokyo, 2018:1-4.
